Hafniumoksiidi aatomkihtsadestuse keemia ja räninitriidil põhineva välkmälu kvaliteet… Mis neil ühist on?

Väga skemaatiliselt, kuid põhimõtteliselt adekvaatselt võib ette kujutada kahte laia keelutsooniga isoleerivat metalloksiidkihti, milliste vahele on sadestatud kitsama keelutsooniga isolaator, pooljuht või juht (Joonis). Korrusstruktuur on omakorda sadestatud kahe elektrone juhtiva kihi ehk elektroodi vahele. Üks nendest laia keelutsooniga kihtidest on sadestatud eriti õhukesena (1-3 nm) aluselektroodi peale ja läbi selle võib, rakendades elektrivälja, tunnelleerida elektrone kitsama keelutsooniga kihti, kirjutab Fyysika.ee.
Kui elektriväli maha võtta, jäävad elektronid kahe laia keelutsooniga kihi ehk kahe energeetilise barjääri vahele lõksu pidama. Kui rakendada elektrivälja vastupidises suunas, siis võib need elektronid jälle aluselektroodi tunnelleerida. Niiviisi võib saavutada vahepealses kihis vaheldumisi elektronide liiasuse või vaeguse. See tähendab, et meil on laengute kondensaator, mis võib kanda infobitte “1” või “0”. See teine laia keelutsooniga kiht, mis ei ole kontaktis alumise elektroodiga ehk tunnelelektronide allikaga, toimib elektronide voo suhtes stopperkihina ja on sadestatud paksemana, vältimaks elektronide liikumist (tunnelleerumist) järgmise ehk pealmise elektroodini.
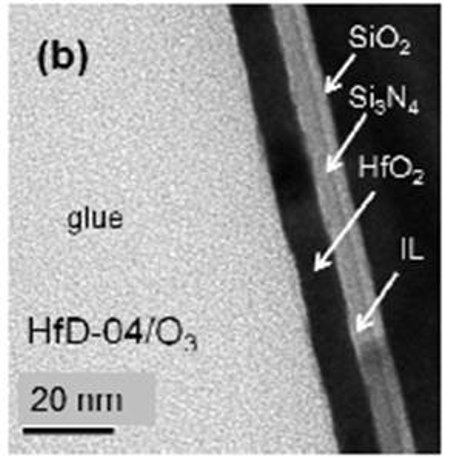
Traditsiooniliselt on selliste korrustruktuuridena kasutatud SiO2/Si3N4/SiO2 kolmikkihti, ehk nn. SONOS-tüüpi mälustruktuuri. Edasi tuleb arvestada, et seadmed muutuvad järjest pisemateks, mäluelementide pindalad samuti koos üldiste mõõtmetega, ja mäluelementide pindtihedus kasvab märkimisväärselt iga tehnoloogilise põlvkonnaga. Seetõttu tuleb kasutada materjale, mis võimaldaksid saavutada mäluelemendi paremat füüsikalis-elektroonilist kvaliteeti järjest pisemate füüsiliste mõõtmete juures. Turule on tänaseks jõudnud ka metalloksiidist stopperkihile (nt. tantaali oksiid, Ta2O5) rajatud, ehk nn. TANOS-välkmälud. Otsingud jätkuvad. Tantaali oksiid ei ole veel see kõige laiema keelutsooniga ja elektrone kõige paremini pidurdav materjal. Oleks hea kui Ta2O5 asemel saaks kasutada midagi paremat, näiteks hafniumi oksiidi (HfO2).
Materjalide kihtide füüsikalised omadused sõltuvad suuresti materjalide sünteesiks kasutatava protsessi iseärasustest ning selle protsessi aluseks olevatest keemilistest reaktsioonidest. Ühes Kreeka, Soome ja Eesti päritoluga teadlaste ühistöös on just avaldatud mõningaid lisaandmeid selle kohta, kuidas kasvab ja funktsioneerib HfO2 stopperkiht välkmälukondensaatoris (vt. allikas. http://www.scientific.net/AMR.324.42). HfO2 sadestati kasutades kahel erineval lähteaineklassil – hafniumi alküülamiididel ja hafniumi tsüklopentadienüülidel – põhinevat keemiat. Lugeja võib saada lisainformatsiooni kasutatud lähteainekeemia kohta ka A. Tamme doktoriteesidest aadressilt http://dspace.utlib.ee/dspace/handle/10062/15838.
Ühistöös leiti, et – tõepoolest – selline metallorgaaniline aluskeemia lubab kasvatada umbes 7-10 nanomeetri paksusi stopperkihte, mis tõesti aitavad elektrone lõksustada. Nähti, et elektronide edasi-tagasi tunnelleerimine tekitab mitmevoldilise mäluakna infot kirjutava ja infot kustutava pinge vahel. Väga olulisi erinevusi erinevate lähteainete klasside vahel seejuures ei täheldatudki. Tegemist oli alusuuringuga ja tööstuslikult skaleeritavaid tulemusi veel ei oodatudki. Võib vaid märkida, et arenguruumi on: üks mälupulk peaks andmeid kindlalt säilitama umbes 10 aastat ja seda esialgsed tavalise labori tingimustes tehtud, kuid ajas tulevikku ekstrapoleeritavad katsed veel ei näidanud. Edasised uuringud tuleks läbi viia puhasruumis, s.t. tegelikule tootmisprotsessile lähedasemates tingimustes.
Jälgi Forte uudiseid ka Twitteris!